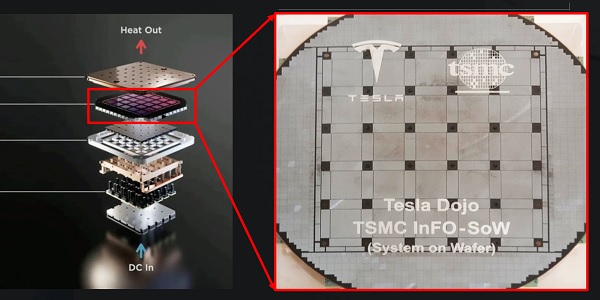
▲ TSMC가 반도체 웨이퍼 한 장을 모두 패키징으로 활용하는 신기술을 개발하고 있다. 테슬라 슈퍼컴퓨터에 쓰이는 반도체 패키징 기술 이미지.
대만 TSMC는 주요 고객사의 차세대 제품을 노려 반도체 웨이퍼(원판)를 통째로 활용하는 신기술 상용화를 추진하고 있다.
대만 공상시보는 3일 “반도체 설계 기업들이 성능을 높이기 위해 면적을 넓히는 추세가 이어지고 있다”며 “이는 관련 패키징 기업에 도전과제를 안기고 있다”고 보도했다.
엔비디아가 출시를 앞둔 새 인공지능 반도체 ‘블랙웰’ 시리즈는 업계에서 가장 큰 그래픽처리장치(GPU) 기반 제품이 될 것으로 예상된다.
여러 개의 GPU와 고대역폭 메모리(HBM) 등을 하나의 패키징으로 조립하는 기술이 쓰이는데 반도체 수가 늘어나고 면적이 넓어질수록 기술 난도가 높아진다.
공상시보는 엔비디아와 AMD 등 인공지능 반도체 주요 기업이 모두 이에 따른 어려움을 겪게 될 것이라며 반도체 패키징 기술의 중요성이 더욱 커질 수밖에 없다고 바라봤다.
TSMC는 현재 엔비디아와 AMD의 인공지능 GPU 생산을 사실상 독점하고 있다. 자연히 TSMC의 패키징 기술 발전도 고객사의 원활한 신제품 출시와 기술 발전에 중요하다.
공상시보는 TSMC가 2027년 양산을 목표로 CoW-SoW 패키징 기술을 개발하고 있다고 보도했다.
이는 GPU와 HBM 등 여러 반도체를 개별로 조립하는 대신 아예 반도체 웨이퍼 위에 직접 올려서 하나의 패키지로 묶는 방식이다.
결국 이른 시일에 반도체 웨이퍼 하나를 통째로 사용하는 거대한 인공지능 반도체 제품이 상용화될 수 있다는 의미다.
공상시보는 “TSMC는 인공지능 반도체 대형화와 더 많은 HBM 탑재가 필요해지는 추세에 맞춰 CoW-SoW 상용화를 추진하고 있다”고 전했다.
이러한 기술은 이미 TSMC가 테슬라 ‘도조’ 슈퍼컴퓨터에 공급하는 반도체 패키징 기술에 일부 활용됐다.
공상시보는 “차세대 인공지능 반도체는 성능과 전력효율 등 측면에서 인공지능 데이터센터의 기준에 맞춰 상당한 기술 혁신을 이뤄내야 한다”며 TSMC의 패키징 기술 중요성이 더욱 높아질 것으로 바라봤다. 김용원 기자




![[여론조사꽃] 이재명 지지율 73.6%로 2.9%p 내려, 민주당 55.9% vs 국힘 24.5%](https://businesspost.co.kr/news/photo/202605/20260511111534_53025.jpg)






